반도체 후공정 첨단 패키징이 중요해짐에 따라 본딩과 TSV의 중요성도 더 커지고 있습니다. 첨단 패키징은 수직으로 쌓거나 서로 다른 칩들을 쌓는 것을 말합니다. 본딩 방식에는 열압착 본딩, MR-MUF, 레이저 본딩, 하이브리드 본딩 등이 있습니다. 첨단 패키징과 본딩에 대해 알아봅시다.
(2023년 8월 26일 방송)
1. 첨단 패키징


미세화로는 한계에 봉착해서 후공정 첨단 패키징 향상으로 속도를 높임
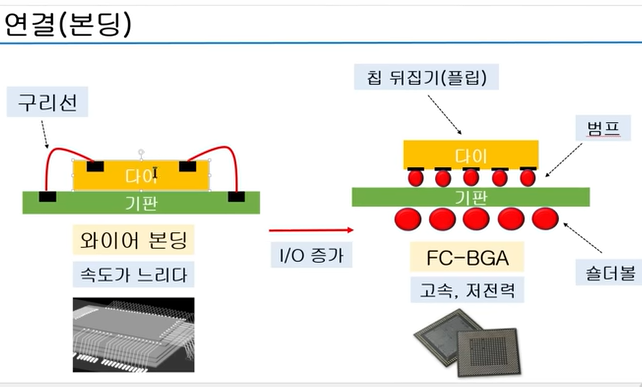

WLP는 TSMC가 개발해서 대박 난 패키징 방식 - 패키징 먼저 하고 자른다.
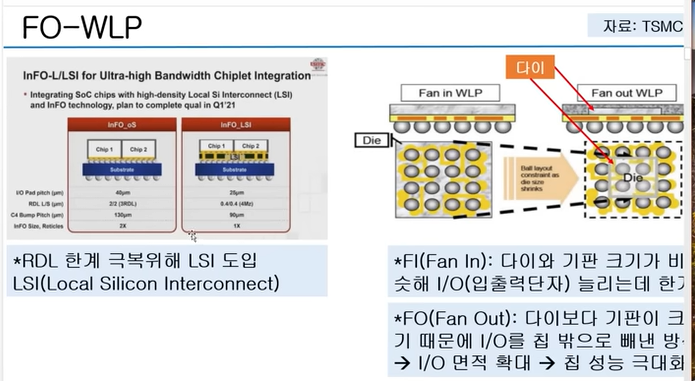
FO(Fan Out) : 칩보다 기판이 크다. 칩 성능을 극대화. 입출력 단자를 밖으로 빼냈다.

TSMC가 후공정 패키징을 잘함

인터포저가 없으면 2D, 있으면 2.5D


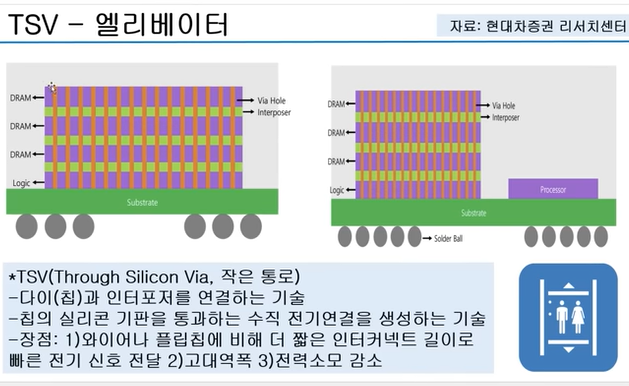
TSV는 칩과 인터포저 사이의 엘리베이터

TSV 공정은 전공정에 해당함
건식 식각해서 구리를 증착함 → 평탄화(CMP), 그리고 나서는 후공정 단계


H100을 만들어 주는 회사가 TSMC.
엔비디아는 AI 가속기와 소프트웨어 '쿠다'까지 같이 제공하기 때문에 점유율이 높음.
AMD는 소프트웨어 개발이 과제임.
삼성전자가 엔비디아 수주를 받아야 함.
2. 본딩

한미반도체, 네덜란드 BESI가 본딩 회사
본딩을 위해서는 장비가 필요함. 후공정은 본딩
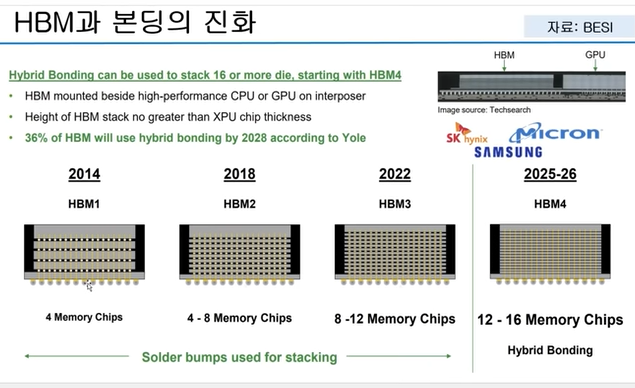
1) TC 본딩 (열압착 연결)

단점 - 시간이 오래 걸린다.
가장 전통적인 방식
2) MR-MUF

SK하이닉스가 한미반도체와 공동 연구하여 개발하여 세계 최초로 HBM3에 적용한 본딩 방식.


오븐에 넣어서 한 번에 대량으로 본딩 - 생산성 증가

MR-MUF는 칩이 휘어지는 것도 제어할 수 있고, 불량이 준다.
TC-NCF는 균일하지 않은 부분도 있다고 함.
하지만, 이것은 하이닉스에서 나온 자료이므로 고려하시기 바람
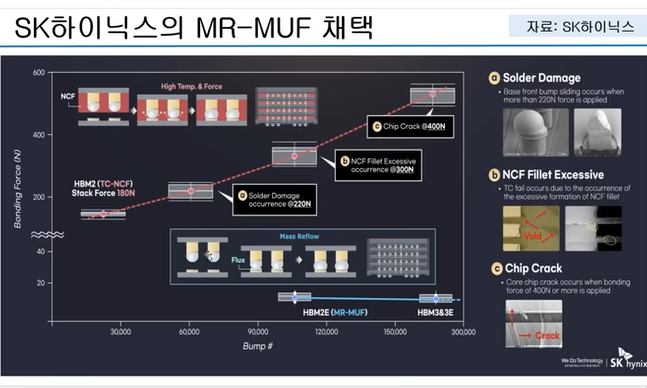

3) 레이저 리플로우

생산성 10배, 휘어지지 않는다고 함.



4) 하이브리드 본딩

서로 다른 소재를 붙인다고 하여 하이브리드 본딩인데, 궁극적으로는 하이브리드 본딩으로 가려고 함.


오염물질이 조금만 있어도 난리가 나기 때문에 세정 장비, 검사 장비가 중요함.
패키징이 중요해 질수록, 검사나 수율 관리가 더 중요해진다.

후공정이 진짜 중요함
* 여기 있는 밸류체인 기업은 사실과 다를 수 있으니 유의 바람
3. 염블리와 함께 링크
(2023년 8월 26일 방송)
https://youtu.be/6m71TD4Q3H0?si=lw7UFWLzkdCrBsGd
'주식 - 염블리와 함께 배우기 > 반도체' 카테고리의 다른 글
| 염블리와 함께배우기 반도체 - 확산(디퓨전) 공정(CVD, ALD 증착, 원익QNC, 유진테크, 아스플로, 엘오티베큠) (1) | 2024.01.24 |
|---|---|
| 염블리와 함께배우기 반도체 - 본딩 기업(미코,에프엔에스테크,케이씨텍,프로텍) (0) | 2024.01.23 |
| 염블리와 함께배우기 - 반도체 치료 Part2(반도체 수율향상/저스템, 제우스, 엑시콘, 티에프이) (0) | 2024.01.21 |
| 염블리와 함께배우기 - 반도체 치료하는 나이팅게일 Part1(반도체 수율향상 기여 기업 소개/지오엘리먼트, 기가비스) (0) | 2024.01.20 |
| 염블리와 함께배우기 반도체 - 디자인 하우스와 IP(가온칩스, 에이디테크놀로지, 오픈엣지테크놀로지) (0) | 2024.01.20 |



